DHI Board Uewerflächenbehandlungstechnologie Kueleserie direkt Platen
1.Geschicht vu Kuelestoff Serie direkt plating
De Kuelestoffserie direkt Plackéierungsprozess gouf fir 35 Joer an der Circuit Board Industrie wäit benotzt. Prozesser, déi wäit an der Industrie benotzt ginn, enthalen schwaarz Lächer, Sonnendäischtert a Schatten. D'Original Schwaarzt Lach Direktverkleedungstechnologie gouf 1984 patentéiert an ass kommerziell erfollegräich als Platen FR-4 duerch Lach Panel Prozess.
Well de schwaarze Lach e Beschichtungsprozess ass, net e Redoxprozess wéi chemesche Kupferwäsch, ass d'Technologie net empfindlech fir d'Uewerflächeaktivitéit vu verschiddenen dielektresche Materialien a kann mat Material handhaben déi schwéier metalliséiere kënnen. Dofir gouf dëse Prozess wäit an Polyimidfilmer a flexiblen Circuiten, performant oder speziellt Material, wéi Polytetrafluoroethylen (PTFE) benotzt. Déi direkt Plackéierungstechnologie vu Kuelestoff a Grafit ass fir Raumfaarttechnik a militäresch Avionikapplikatiounen approuvéiert an entsprécht den Ufuerderunge vum Abschnitt 3.2.6.1 vun der IPC-6012D Spezifikatioun.
2. Circuit Board Entwécklung
Mat dem Bedierfnes fir gedréckte Circuit Board Design, hunn direkt Elektropläterprozesser sech an de leschte Joeren weider entwéckelt. Wéinst dem Miniaturiséierungs Drive, vu Leadkomponenten bis Uewerflächenmontagekomponenten, huet PCB Design sech entwéckelt fir sech u Mikrokomponente mat méi Pins unzepassen, wat zu erhéichte PCB Schichten, méi décke Circuit Boards an duerch Lächer resultéiert Den Duerchmiesser ass méi kleng. Fir den Erausfuerderunge vum héijen Aspekt Verhältnis gerecht ze ginn, sollten déi technesch Spezifikatioune vun der Produktiounslinn d'Verbesserung vum Léisungstransfer an den Austausch vu Mikroporen involvéieren, wéi zum Beispill d'Benotzung vun Ultraschallwellen fir séier d'Poren naass ze maachen an Loftblosen ewechzehuelen, an de Fäegkeet fir de Loftmesser an den Trockner ze verbesseren fir déck Circuiten effektiv ze trocken. Kleng Lächer um Bord.
Zënterhier sinn PCB Designer an der nächster Stuf agaangen: Blannschlécher Honger, d'Zuel vu Stifter an d'Densitéit vum Kugelraster iwwerschreiden d'Bordoberfläche verfügbar fir Buerungen a Verkabelungen. Mat dem 1.27mm bis 1.00mm Gitter vu Ballgitter Array Packagen (BGA) an dem 0.80mm bis 0.64mm Gitter vu Chip Skala Packagen (CSP) sinn Mikro Blind Lächer zu enger Waff fir Designer ginn fir d'Erausfuerderunge vun der HDI Technologie gerecht ze ginn.
1997 hu Feature Telefonen den 1 + N + 1 Design fir Masseproduktioun benotzt; dëst ass en Design mat mikroblannene Lächer an der Uewerfläch um Schichtkär. Mat dem Wuestum vum Handelsverkaaf, Vir-Ätsche Fënsteren an CO2 Laser, UV, UV-YAG Laser a kombinéierten UV-CO2 Laser fir Mikro blann Lächer ze bilden. Mikroblann Vias erlaben Designer ënner de Blanne Vias ze rennen, sou datt se méi Pin Gitter nei verdeele kënnen ouni d'Zuel vun de Schichten eropzesetzen. HDI gëtt de Moment wäit an dräi Plattforme benotzt: Miniaturiséierter Produkter, High-End Verpakung an héichleeschtend elektronesch Produkter. Miniaturiséierung am Handy Design ass de Moment déi produktivst Uwendung.
3. Direkt Platen
Direkt Plattesystemer wéi schwaarz Lächer mussen technesch Hindernisser iwwerwannen fir de Metalliséierungs Erausfuerderunge vu blanne Lächer an HDI Mikrovias z'erreechen. Wann d'Gréisst vum Blanne Lach reduzéiert gëtt, gëtt d'Schwieregkeet fir Kuelestoffpartikelen um Buedem vum Blanne Lach ewechzehuelen, awer d'Propretéit vum Fong vum Blanne Lach ass e Schlësselfaktor deen d'Zouverlässegkeet beaflosst; dofir ass d'Entwécklung vun neie Botzmëttelen a Mikro-Ätzungsmëttel d'Blannheet ze verbesseren Wéi de Buedem vum Lach botzt.
Zousätzlech, baséiert op Theorie a praktescher Erfahrung, gouf d'Düsendesign vun der Mikro-Erosiounssektioun modifizéiert fir eng Kombinatioun vu Spray-Soaking-Spraying Konfiguratioun ze sinn. Praxis huet sech als en effektiven Design bewisen. D'Distanz tëscht der Düs an der Uewerfläch vum Circuit Board gëtt reduzéiert, d'Distanz tëscht de Düsen gëtt reduzéiert, an d'Spray Impact Kraaft op der Circuit Board gëtt erhéicht. Duerch d'Detailer ze ergräifen, kann den neien Düsendesign effektiv en héicht Aspekt Verhältnis duerch Lächer a blann Lächer handhaben.
Mat der Entwécklung vun der nächster Generatioun vu Smart Telefonen hunn d'Fabrikanten ugefaang all Schicht vu gestapelten blannem Loch Design ze benotzen fir duerch Lächer z'eliminéieren, wat en Trend ausgeléist huet, well d'Linnebreet an d'Linneafstand vu 60μm op 40μm reduzéiert goufen, d'Produktioun vu Circuit Boards D'Original Kupferfoliedicke, déi am Prozess benotzt gouf, gëtt stänneg vun 18 μm op 12 μm op 9 μm reduzéiert. An all iwwerlagert Schicht vun all Schichtkreesserplat muss eemol metalliséiert an galvaniséiert ginn, wat d'Kapazitéitsfuerderung vum naasse Prozess staark erhéicht.
Smartphones sinn och d'Haaptbenotzer vu flexiblen a starre-Flex-Circuiten. Am Verglach mam traditionelle chemesche Kupfer Plackéierungsprozess ass d'Applikatioun vun der direkter Plackéierung bei der Produktioun vun all Schicht, flexiblen Circuit Board (FPC) a starre-flex Circuit Board wesentlech eropgaang, well dëse Prozess mam traditionelle chemesche Kupferprozess Verglach gëtt , manner Waasserverbrauch, manner Ofwaasserproduktioun
4. PCB's ëmmer méi schmuel Linnebreet / Zeilabstandsufuerderungen erfuerderen strikt Kontroll vun Ätzendéift
Elo, déi lescht Generatioun vu Smartphones a fortgeschratt Verpakung adoptéieren no an no déi alternativ semi-additiv Method (mSAP). mSAP benotzt 3μm ultra-dënn Folie fir 30/30 Micron Linnebreet a Pitch Design z'erreechen. Am Produktiounsprozess mat ultra-dënner Kupferfolie ass et noutwendeg fir de Betrag vun der Bisskorrosioun vu Mikroetsungsrillen an all Prozess ze kontrolléieren. Besonnesch fir traditionell chemesch Kupfer Tauchen an direkt Plackeprozesser, muss de Betrag vun der Bisskorrosioun vun der Uewerfläch Kupferfolie ganz präzis kontrolléiert ginn
5. Fortschrëtter an der Ausrüstungskonfiguratioun
Fir den direkten Plackéierungsprozess ze optimiséieren fir dem mSAP Prozess ze passen, goufen e puer verschidden Ausrüstungsdesignen no an no op der experimenteller Linn getest ier se a voller Produktioun gesat goufen. D'Testresultater weisen datt duerch e gudden Ausrüstungsdesign eng eenheetlech leitend Kuelestoffbeschichtung kann ënner engem breede Betribsberäich geliwwert ginn.
Zum Beispill am direkten Plackéierungsprozess vun der Kuelestoffserie gëtt eng patentéiert Roller Konfiguratioun benotzt fir d'Kuelestoffbeschichtung méi eenheetlech ze maachen. A reduzéiert d'Quantitéit vu Kuelestoffdepositioun op der Uewerfläch vum Produktiounsbrett, reduzéiert d'Quantitéit vu Kuelestoffsuspension, a gläichzäiteg verhënnert d'exzessiv déck Kuelestoffschicht an de Corner vu blannem Lächer oder duerch Lächer.
D'Equipementspezifikatioune vum Post-Microetching Tank goufen och nei designt. Egal ob den Ënnergrond vum Blanne Lach 100% komplett propper ass, ass dat betrëfft Qualitéitsproblem vum Hiersteller. Wann et Kuelestoffreschter um Enn vum blanne Lach ass, kann et den Test wärend dem elektreschen Test duerchgoen, awer well de Querschnittsberäich vun der Leitung reduzéiert ass, gëtt d'Bindungskraaft och reduzéiert, wat zu Broch féiert wéinst dem Fehlen vum thermesche Stress während der Montage De Problem vum Echec. Well den Duerchmiesser vum Blanne Lach vun den traditionelle 100 Mikroun op 150 Mikroun op 80 Mikroun op 60 Mikroun reduzéiert gëtt, ass d'Aktualiséierung vun den Ausrüstungsspezifikatioune vun der Mikroetsungsruef kritesch fir d'Produktzouverlässegkeet.
Duerch Testen a Fuerschung fir d'Ausrüstungsspezifikatioune vum Mikro-Ätzentank z'änneren fir d'Prozessfäegkeet ze verbesseren fir de Kuelestoffreste komplett um Buedem vum blanne Lach ewechzehuelen, gouf et op Masseproduktiounslinnen applizéiert. Déi éischt grouss Verbesserung beinhalt d'Benotzung vun duebelen Äschegrillen fir méi präzis Kontroll vun der Quantitéit vum Bëss ze bidden. An der éischter Stuf gëtt de gréissten Deel vum Kuelestoff op der Kupferoberfläche ewechgeholl, an der zweeter Stuf gëtt frësch a propper Mikroetsungsléisung benotzt fir ze verhënneren datt d'Kuelestoffpartikelen zréck an d'Massproduktiounskaart kommen. An der zweeter Stuf gouf d'Technologie vum Reduzéiere vu Kofferdrot och ugeholl fir d'Uniformitéit vum Mikroetsing op der Uewerfläch vum Circuit Board staark ze verbesseren.
Reduktioun vun der Variabilitéit vun der Quantitéit vum Biss op der Uewerfläch vum Circuit Board hëlleft de Gesamt Ätzbetrag am Fong vum blanne Lach genau ze kontrolléieren. D'Variabilitéit vum Betrag vum Bëss gëtt streng kontrolléiert duerch d'chemesch Konzentratioun, d'Düsenentwécklung an d'Sprëtzdrockparameter
6. Chemesch Verbesserung
Am Sënn vun der chemescher Verbesserung goufen déi traditionell Pore-Reinigungsmëttelen a Mikro-Ätzungsdrénken getest a modifizéiert, wärend se d'Fäegkeet berécksiichtegen, fir Korrosioun vu Bëss ze kontrolléieren. Déi organesch Zousatzstoffer am Botzmëttel si selektiv nëmmen op der Kofferuewerfläch deposéiert a ginn net op den Harzmaterial ofgesat. Dofir wäerte Kuelestoffpartikelen nëmmen op dës speziell organesch Beschichtung deposéiert ginn. Wann de Circuit Board an d'Mikro-Ätzungsrille erakënnt, huet d'organesch Beschichtung héich Opléisbarkeet an der saurer Flëssegkeet. Dofir gëtt d'organesch Beschichtung vun der Säure an der Mikro-Ätzungsrille erofgeholl, a gläichzäiteg gëtt d'Kupferfläch ënner de Kuelestoffsäiten etstéiert, wat kann beschleunegen Kuelestoffpartikelen op der selwechter Säit ewechhuelen.
En anert Verbesserungsprojet ass datt d'Benotzung vun Zwee-Komponent Mikroetsche kann d'Fäegkeet verbesseren fir Kuelestoffpartikelen ze entfernen an d'Mikroruffegkeet vun der Kupferfolie Uewerfläch ze reduzéieren. Loosst d'Rauheet vun der Kupferoberfläche förderen fir dréche Filmhäfung. D'Testresultater weisen datt de relativ glatem Buedem vum Blanne Loch hëlleft fir d'Zouverlässegkeet vun der Plackéierung am Fong vum Blanne Lach ze verbesseren. No der optiméierter Kuelestoffserie direkt Plackéierungsprozess ass d'Kupferfolie am Fong vum blanne Lach komplett propper gewiescht, wat dem galvaniséierte Koffer erlaabt kann weider op de Kupfergitter op der Kupferfolie wuessen fir déi bescht Plackeadhesioun z'erreechen.
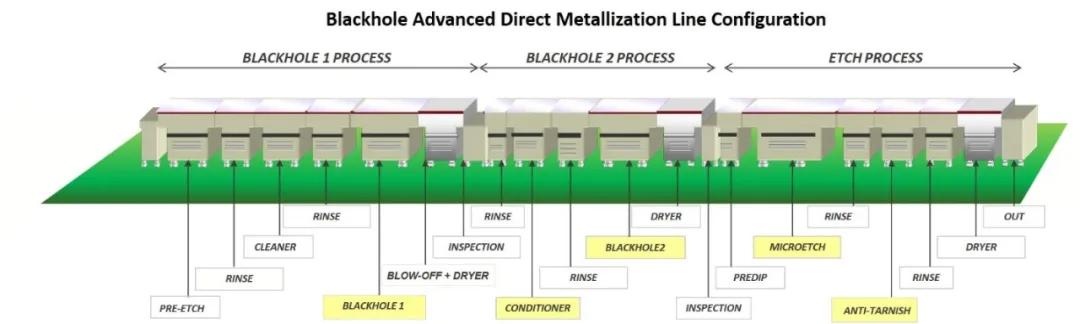
D'Kombinatioun vu Schlësselprozessbehälter a spezifesche Verbesserunge vu Chemikalien bilden en fortschrëttlechen HDI / mSAP Prozess passend fir d'Produktioun mat ultra-dënner Kofferfolie. Duerch eng eenzeg Interface vu Kupfer-Kupfer direkten Bindung gëtt e kontinuéierlech Metallgitter geformt, wat d'Zouverlässegkeet vu blanne Lächer verbessert. D'Behandlung vun der Mikroetsungsgroove erméiglecht déi ideal Mikroruffheet vun der Kupferfolie am Fong vum blanne Lach als e Lachfëllung galvaniséierte Koffersubstrat ze benotzen. Dëst fördert de kontinuéierleche Wuesstum vum Gitter aus galvaniséiertem Koffer um Buedem vum blanne Lach laanscht dem Gitter vun der Kofferfolie. No der normaler héijer Temperatur Hëtztbehandlung sinn d'Kupferkären an engem Gitter arrangéiert a bilden e komplett kontinuéierlech Metallgitter.
Observatioun an Analyse vu FIB Schneideproben fir dënn Scheiwen ze bilden weisen datt d'Interface Linnen uniform an der Korngréisst a Struktur sinn (Figure 5). Nom thermesche Schock oder thermesche Cyclissem ass d'Grenz tëscht der Kupferfolie am Fong vum blanne Lach an dem galvaniséierte Koffer schwéier Et gëtt festgestallt datt et keen Nano-Void ass datt aner Prozesser ufälleg sinn, ausser et gëtt duerch Faktore verursaacht wéi als Oxidatioun oder Verschmotzung.

Fokus Ionstrahl (FIB) Imaging vun der Interface tëscht der galvaniséierter Kupferschicht an dem Zilpad, déi direkt Elektropläterungstechnologie erméiglecht et staark Koffer-Kupfer-Bindung fir gutt ënner thermesche Stress ze maachen.
Direkt Elektroplaterproduktiounslinnen, wéi "schwaarz Lächer", ginn de Moment am Masseproduktiounsprozess vun alternativen Hallefadditive (mSAP) vun 3 Mikron ultra-dënner Kupferfolie benotzt. Dës Systemer benotze verwandte Ausrüstung déi präzis de Betrag vum Mikroetsing an der Masseproduktioun kontrolléiert. Den 12-Layer Circuit Board deen mat dëser Ausrüstung produzéiert gouf ass den 300 Cycle IST Test bestanen. An den uewe genannte Produkter gi schwaarz Lächer am L2 / 10 a L3 / 11 mam mSAP Prozess benotzt. D'Gréisst vun de blanne Lächer ass 80 ~ 100 x 45 ¼¼m, an all Circuit Board enthält 2 Millioune Blann Lächer.
Benotzt AOI fir Kuelestoffreschter am Prozess ze kontrolléieren. D'Inspektiounsresultater weisen datt an der 5.000 PSM / Mount Ausgab keng Mängel festgestallt goufen. D'Elektropléiere vun dëse Circuit Boards gëtt op enger vertikaler kontinuéierlecher Galvaniséierung (VCP) Produktiounslinn gemaach; déi bannenzeg Schicht bestëmmt déi vollplackeg Galvaniséierung vum Zelt-Etch-Prozess, an d'mSAP-Schicht muss Elektropläterung sinn. D'Elektronbackscatter-Diffraktioun (EBSD) Bild an der Figure 6 weist d'Uniformitéit vun der Getreidegréisst op der Interface tëscht dem Zilpad an der galvaniséierter Kofferschicht.